
光デバイスの性能は元基板(ウエハ)の品質に大きく左右されます。本研究室ではGaInAsP、AlGaInAsなどの化合物半導体結晶を、有機金属気相成長装置(OMVPE)を用いて成長しています。材料として、TEGa, TMGa, TMAl, TMIn, ZnH6, AsH3, PH3, CBr4を有しています。

電子ビームを放射し、計算機制御により任意形状のパターンを作製することができます。ビーム径を5nmまで集束することができます。2台有しており、加速電圧は50 keVと100 keVです。DFBレーザの回折格子やSi光集積回路の作製に用います。
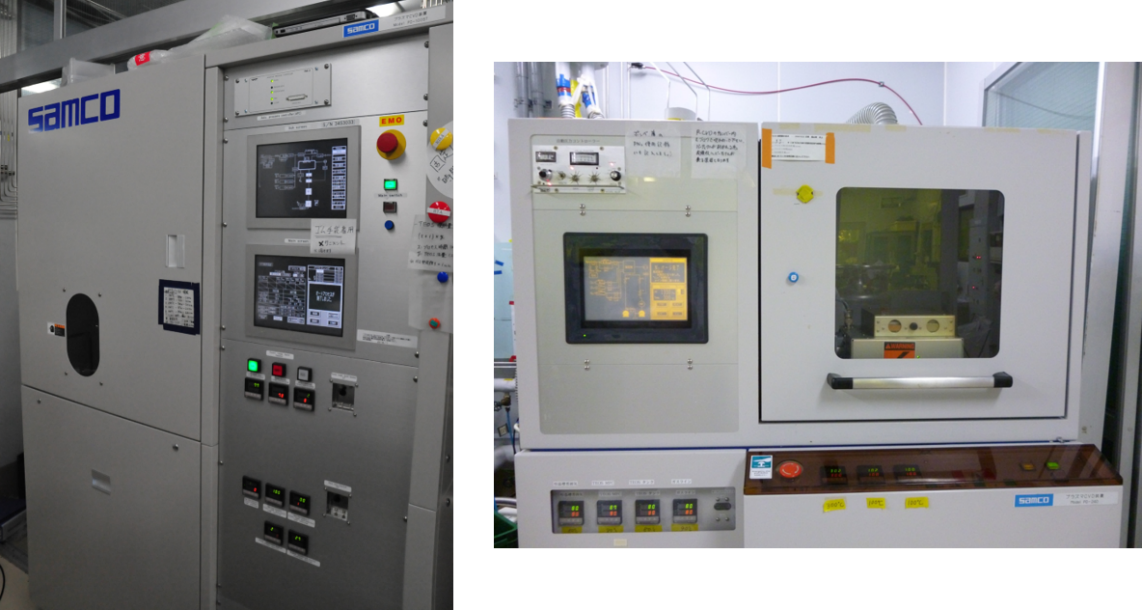
プラズマを用いたCVD装置です。CVD (Chemical Vapor Deposition)の略で、原料となる元素を含んだ化合物をプラズマで分解して化学反応を起こし、加熱された基板表面に高純度の膜を形成する手段のことです。我々の研究室ではTEOSを原料ガスとし、O2を流し、プラズマを立てて基板上にSiO2を成膜しています。SiO2は絶縁膜やマスクとして用いられます。アノード型とカソード型の電極の2台を有しています。

プラズマを用いたCVD装置です。CVD (Chemical Vapor Deposition)の略で、原料となる元素を含んだ化合物をプラズマで分解して化学反応を起こし、加熱された基板表面に高純度の膜を形成する手段のことです。我々の研究室ではTEOSを原料ガスとし、O2を流し、プラズマを立てて基板上にa-Siを成膜しています。

プラズマを用いたCVD装置です。CVD (Chemical Vapor Deposition)の略で、原料となる元素を含んだ化合物をプラズマで分解して化学反応を起こし、加熱された基板表面に高純度の膜を形成する手段のことです。我々の研究室ではトリシリルアミンを原料ガスとし、N2Oを流し、プラズマを立てて基板上にSiONを成膜しています。
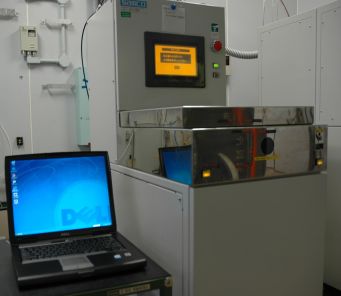
RIE: Reactive Ion Etching
全自動の反応性イオンエッチング装置です。パターン形状の制御性・再現性、及びパターンのエッチング寸法制度が高く、メタンやCF4による低損傷加工が可能になり、ナノオーダーの微細加工ができるようになりました。III-V族やSiO2エッチングに用いられます。
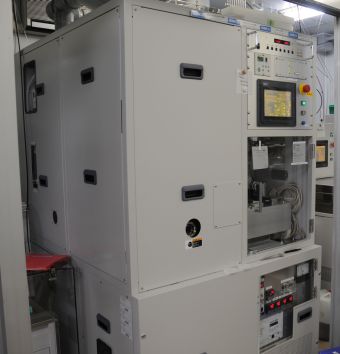
ICP: Inductively Coupled Plasma
誘導結合プラズマ方式により高密度のイオンを生成し、各種半導体材料を高速に異方性エッチングを行うことが可能です。Siフォトニクスの導波路作製に利用されています。

より安定的に低圧においてもICPのプラズマを発生できるようになっています。主にダイヤモンドを加工することを目的とし、トポロジカル構造の作製にも利用しています。

金属を蒸着する装置です。
電子銃(Electron-gun)を用いて金属にエネルギーを与え、金属薄膜を成膜します。

2024年に新しく導入された新型の金属蒸着装置です。
電子銃による蒸着と抵抗加熱による蒸着の2種類を1台で行うことができます。
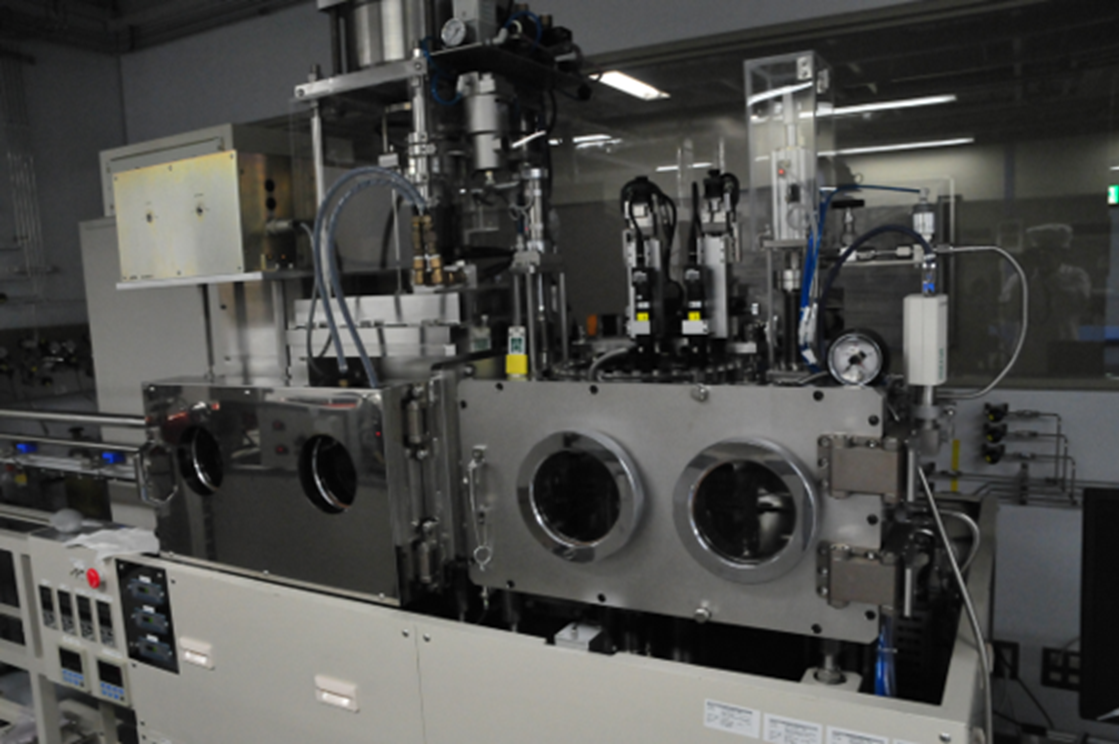
2枚の異なる異種材料ウェハを接合する装置です。
当研究室では主にIII-V族化合物半導体ウェハとSiウェハの接合に用いています。
真空チャンバー内でプラズマやによりウェハ表面を活性化します。
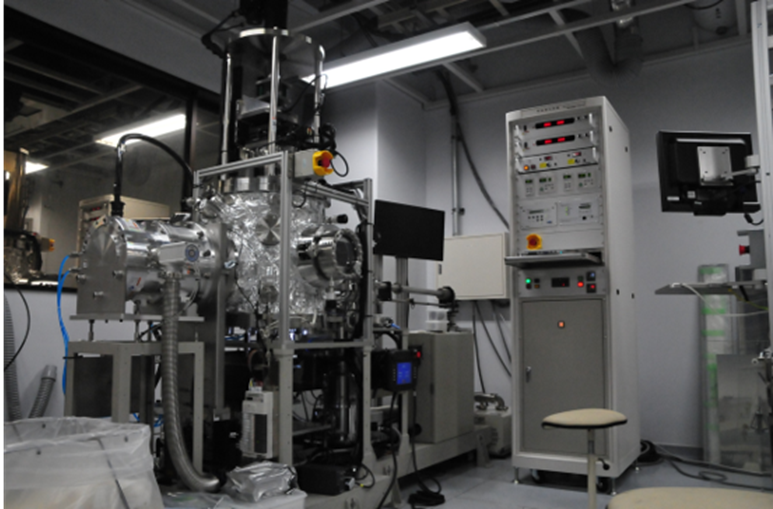
2枚の異なる異種材料ウェハを接合する装置です。
当研究室では主にIII-V族化合物半導体ウェハとSiウェハの接合に用いています。
真空チャンバー内でFAB(Fast Atom Beam)によりウェハ表面を活性化します。

小片をSi基板に接合するための装置です。
プラズマを照射した基板にこの装置を使って接合を行います。
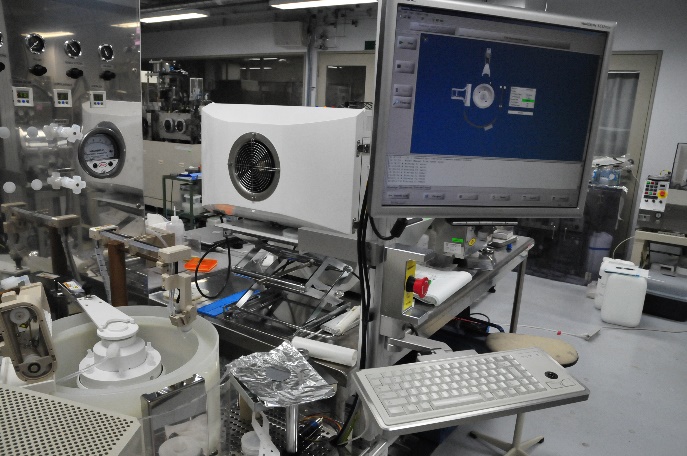
特殊なブラシや超音波を用いてウェハを洗浄する装置です。
ウェハ接合の前処理などに用います。
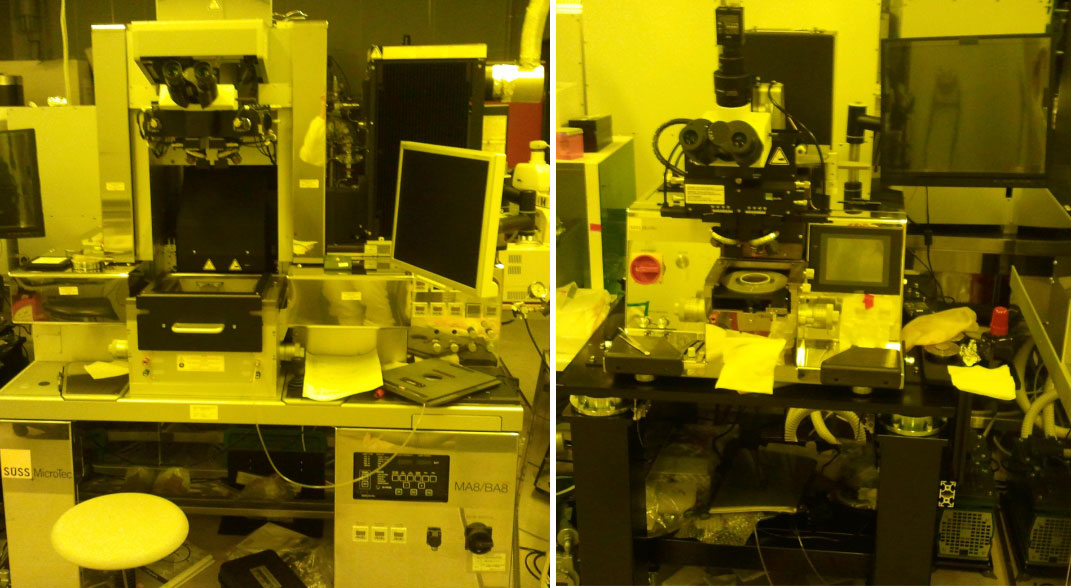
フォトリソグラフィ時に用いる装置です。
ウェハ表面に製膜したレジストに、マスクパターンを転写します。

フォトリソグラフィ時に用いる装置です。
マスクを用いず、DMDミラーとUVレーザを用いて直接レジストにパターンを描画します。

フォトリソグラフィ時に用いる装置です。
上記のものより解像度がよいです。
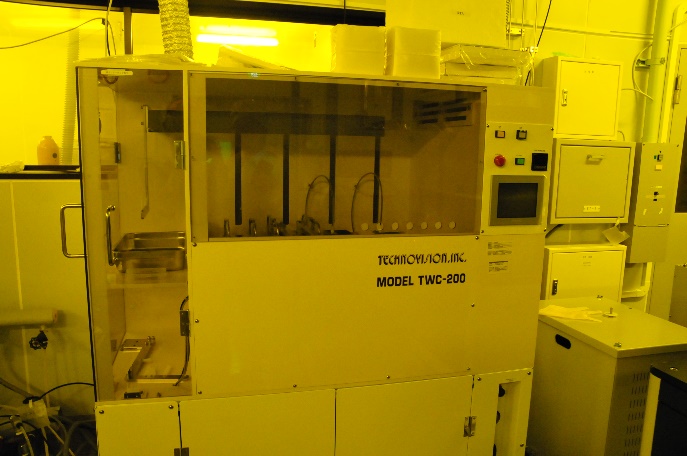
マスクアライナで用いるマスクを洗浄する装置です。

フォトリソグラフィを用いず、原版を押し付けることで基板やポリマーなどにパターンを形成する装置です。我々はメンブレンレーザのためのポリマー接合に利用しています。
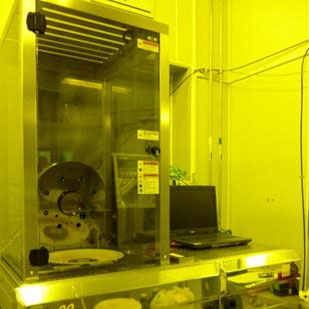
レジストの成膜に使う装置です。
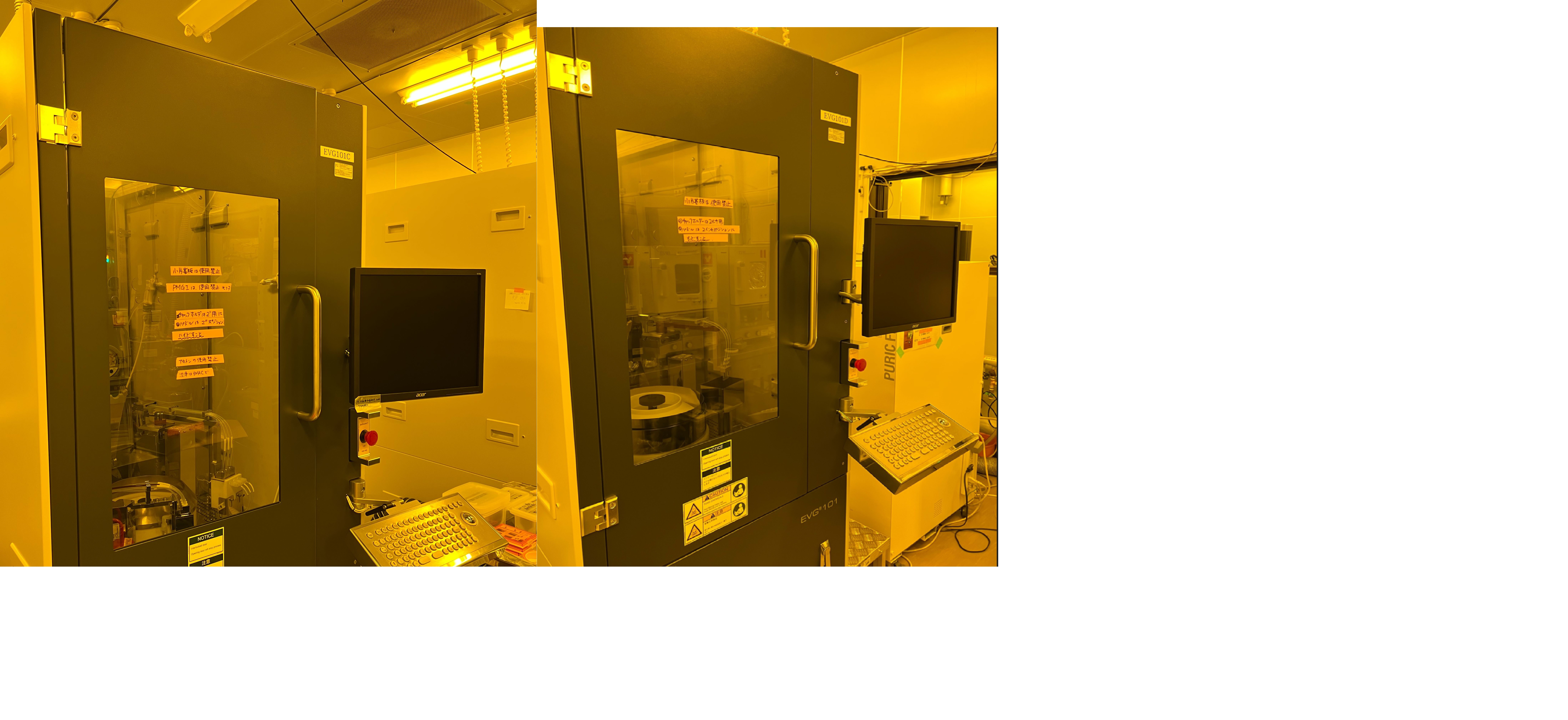
レジストの成膜と現像の装置です。高い精度の均一性、レジスト塗布や現像のオプションの向上、安定的な条件化の動作を目的として利用しています。
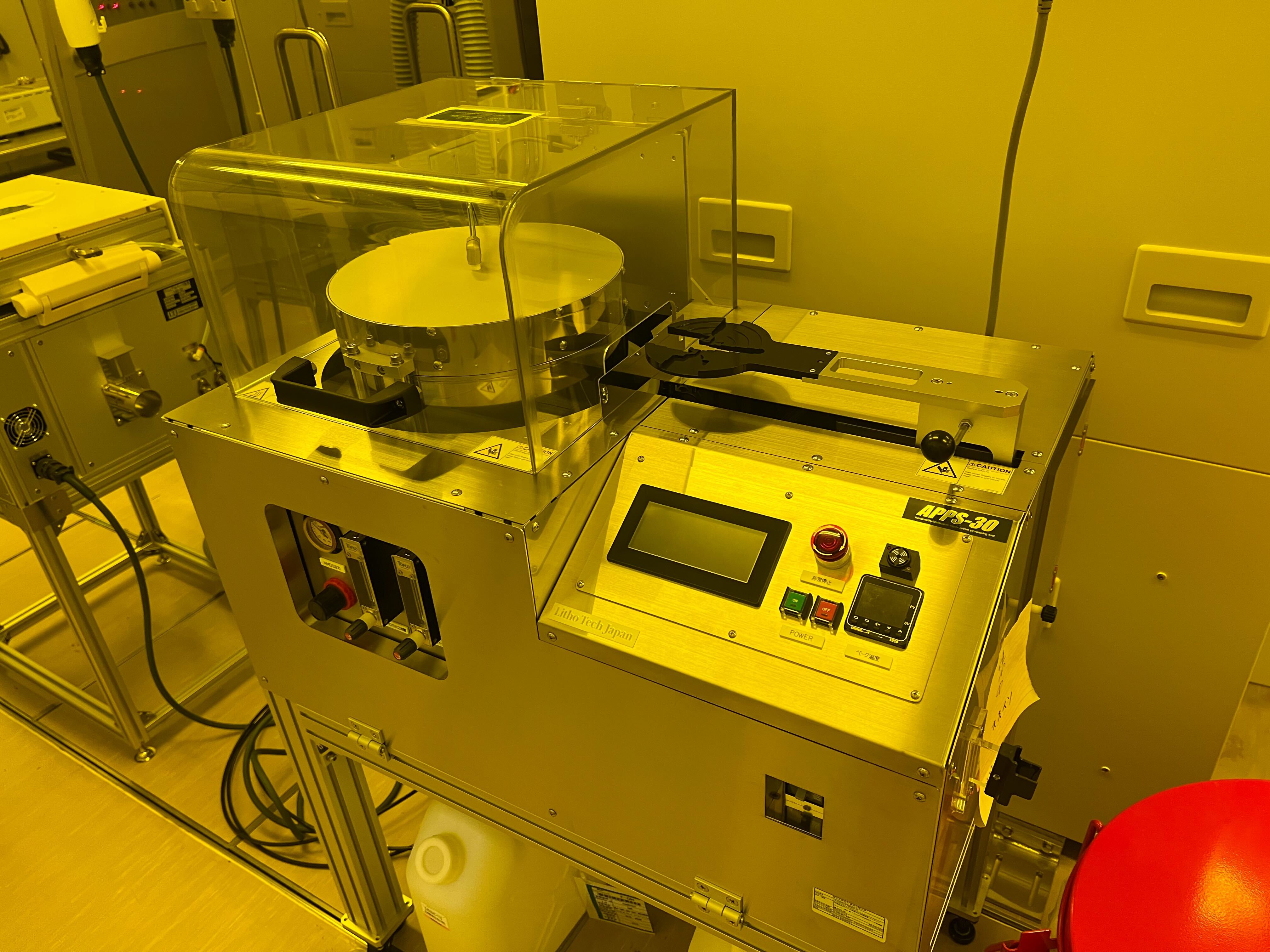
気化させたHMDS(ヘキサメチルジシラザン)を流し高温で反応させるマニュアルHMDSベーク処理装置です。手作業でウェーハをセットした後、自動でHMDSベーク処理を行います。
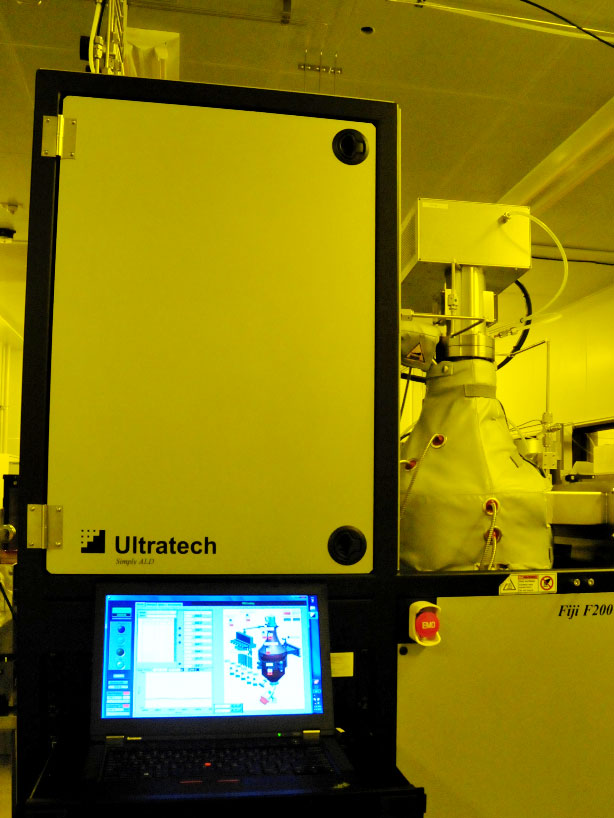
ALD: Atomic Layer Deposition
ウェハ表面に原子層を1層ずつ製膜できる装置です。繰り返すことで、層数を増やすことが出来ます。我々はメサ側面への保護層形成のために利用しています。
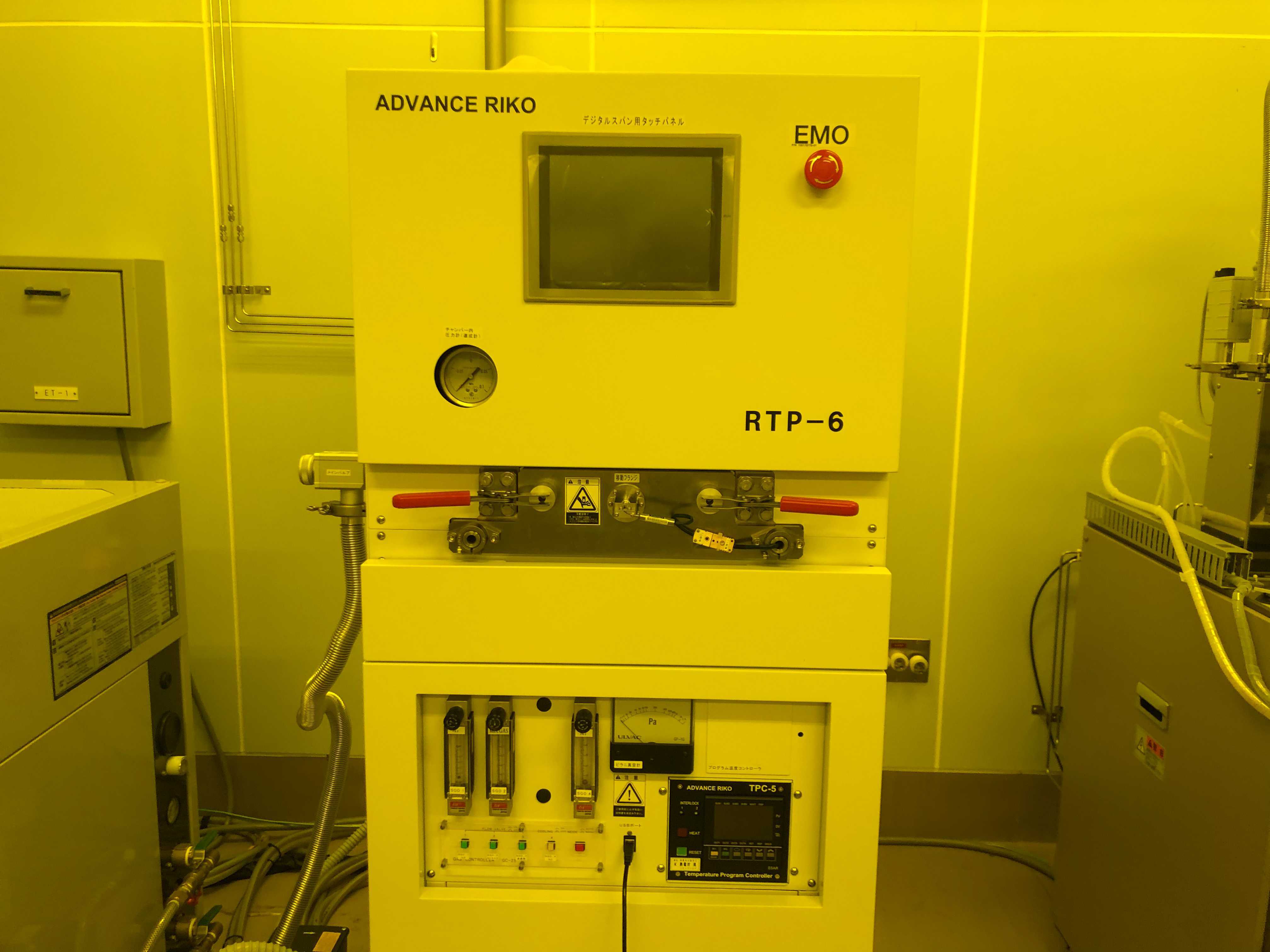
RTA: Rapid Thermal Annealing
ウェハを急速に高温度に加熱できる装置です。コンタクト金属と半導体の接触抵抗を下げる際などに使用します。
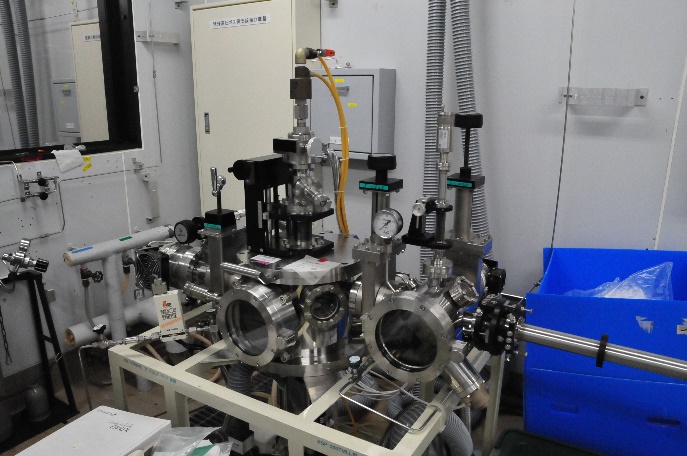
高反射および低反射膜に向けた誘電体などを成膜させる装置です。
加速させたイオンをターゲットにあて、ターゲットから飛んだ材料がウェハに付着し、成膜されます。
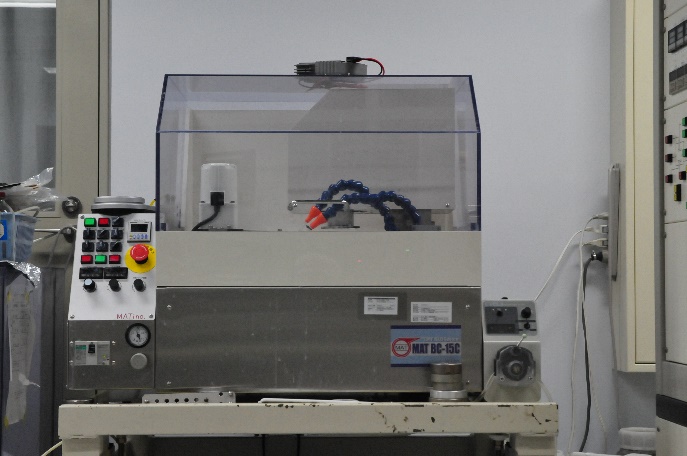
CMP: Chemical Mechanical Polishing
化学研磨剤と研磨パッドにより、ウエハの表面を平坦化することができる装置です。3次元光回路やボンディング前の処理に利用しています。
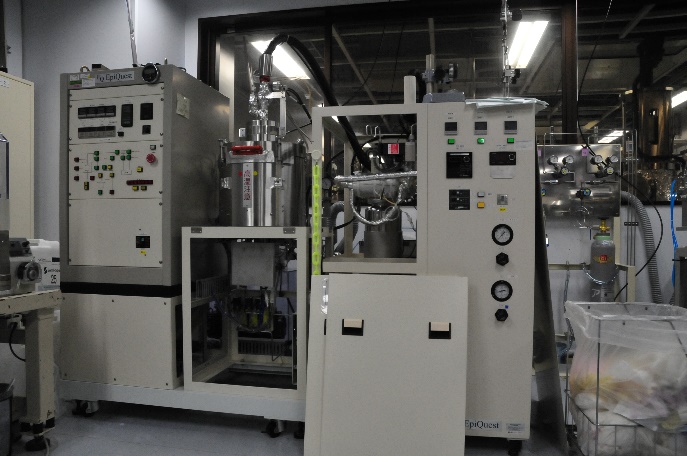
水蒸気酸化を行うことができる装置です。面発光レーザや端面レーザの電流狭窄のためにAlAsおよびAlInAsを酸化します。
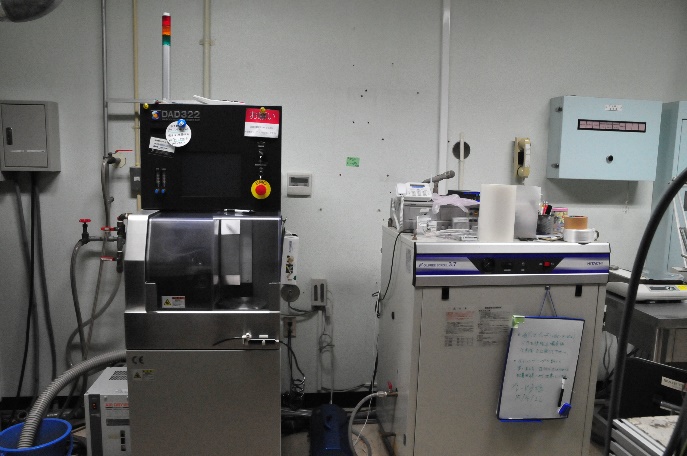
厚膜のチップを切り出す装置です。強度の高いウェハを高速回転する刃を用いて切ることができます。Si導波路を切り出すときに利用しています。
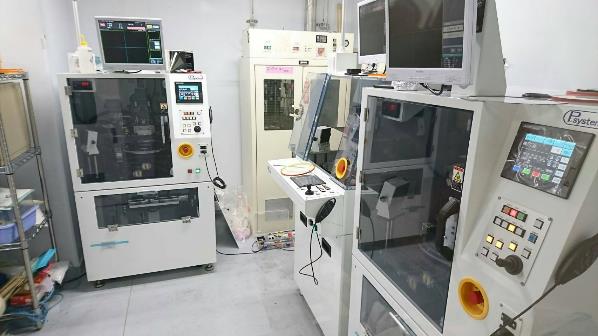
半導体ウェハ・小片を精度よく分割するための装置群です。

分割したウェハを端面を傷つけず、割れないよう取り出しやすくする装置群です。

物体に電子銃を当て、その二次電子を検出し、像として映し出す装置です。
ナノメートルオーダの微細な構造を観察する際に使用します。
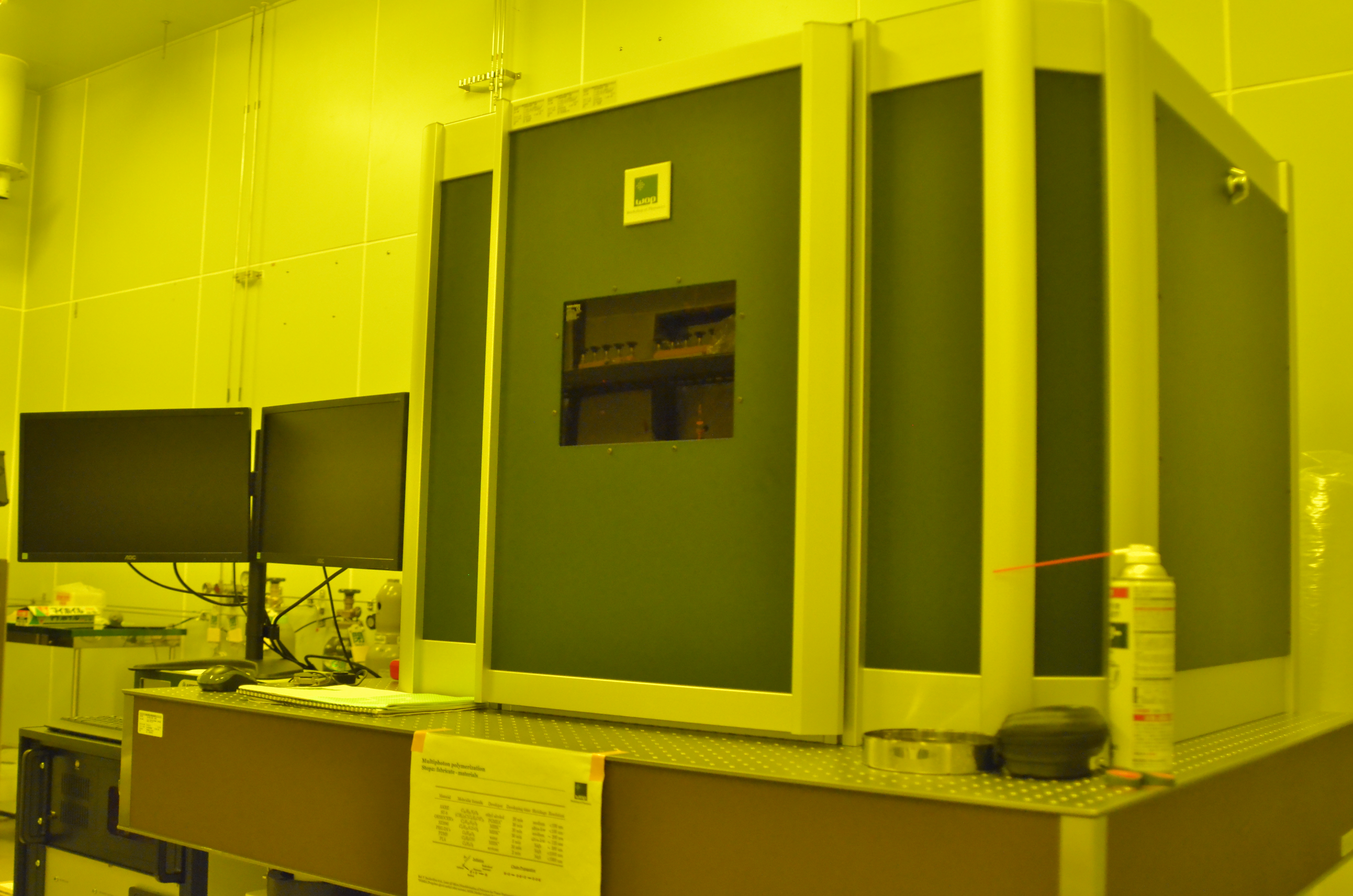
フェムト秒レーザを照射し、計算機制御により任意の3次元形状のパターンを作製することができます。解像度は<200nm。
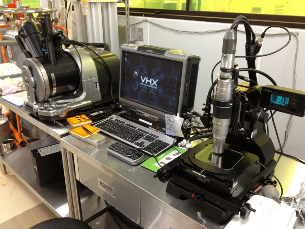
物体に電子銃を当て、その二次電子を検出し、像として映し出す装置です。
ナノメートルオーダの微細な構造を観察する際に使用します。

低加速電圧での高解像度イメージング用に最適化された新しいコールドフィールド エミッション(CFE)ガンを採用しています。このCFE 銃は、高解像度画像を最大200万倍まで拡大することができます

より明確な観察、焦点の調整による優れた分析不要、リアルタイム深さ組成、3Dで表面を可視化します。
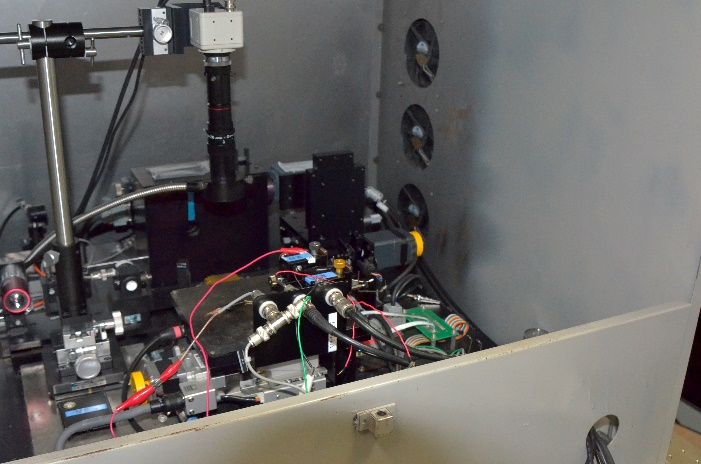
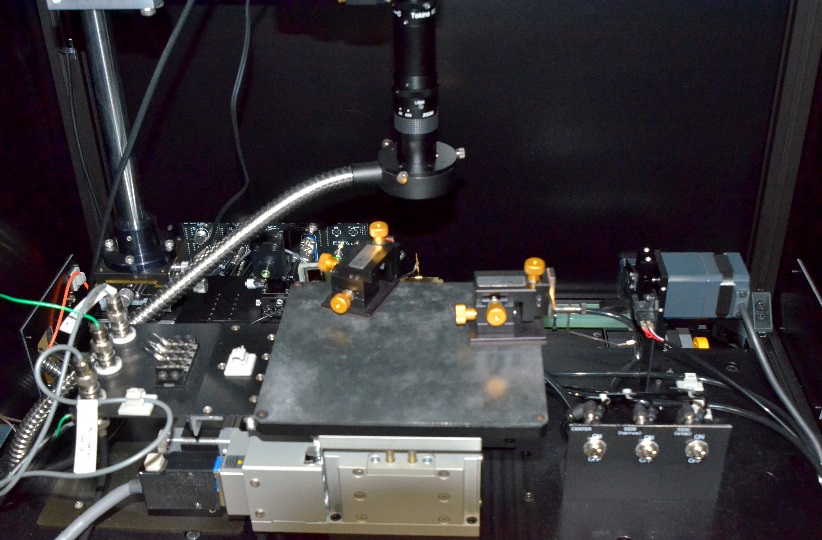
バー状にした複数の素子を自動的に測定することができる装置です。電流-光、電流-電圧特性だけでなく温度特性、スペクトル、遠視野像、近視野像、偏光といったレーザ特性を自動的に測定することができます。

レーザ特性の寿命測定が可能な装置です。
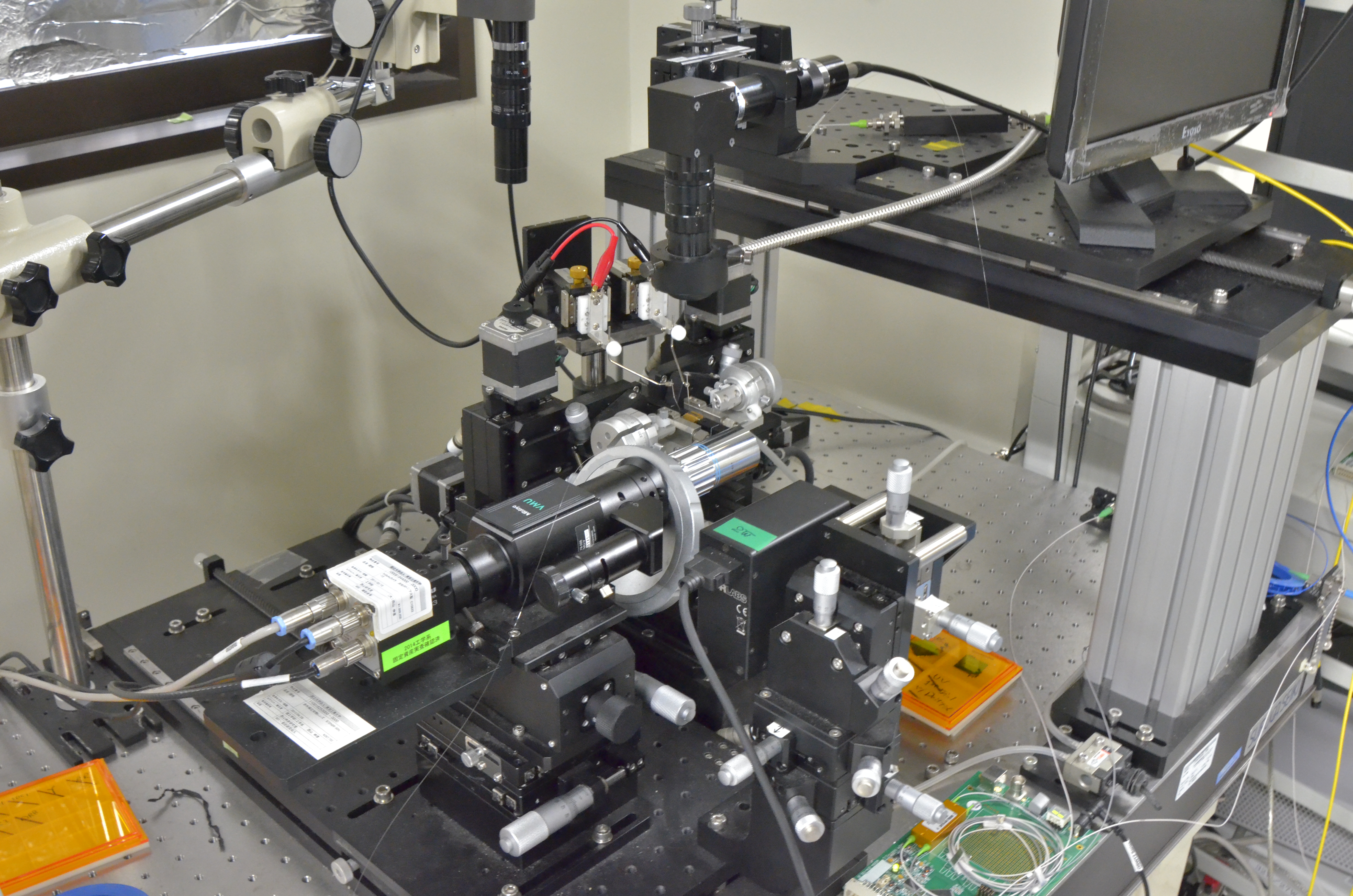
バー状にした複数の素子の透過特性を測定することができる装置です。
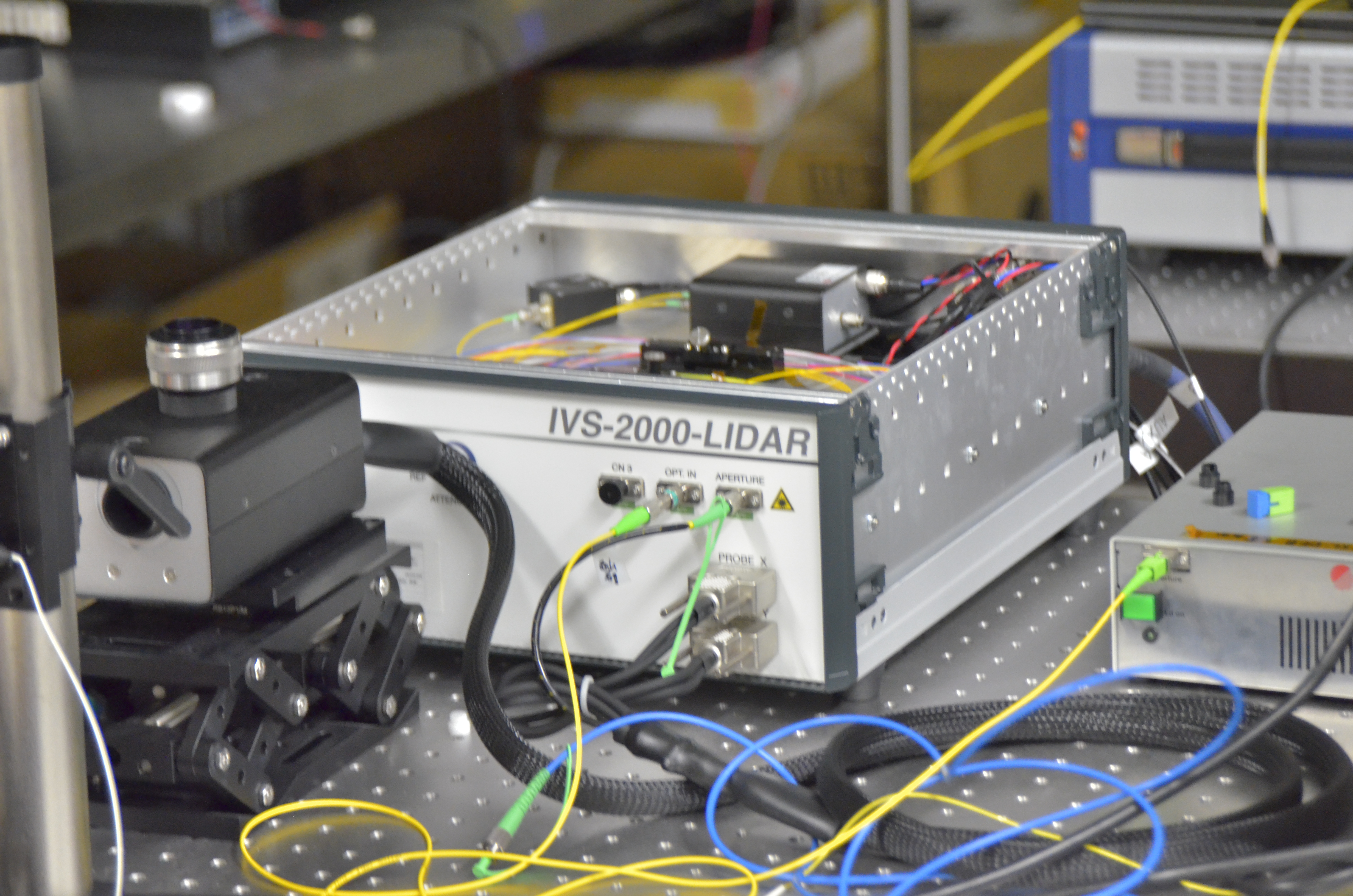
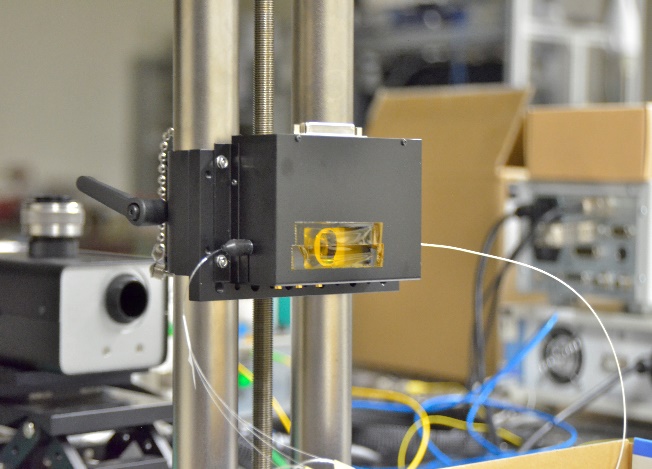
コヒーレントFMCWLiDARを測定することが可能な装置です。
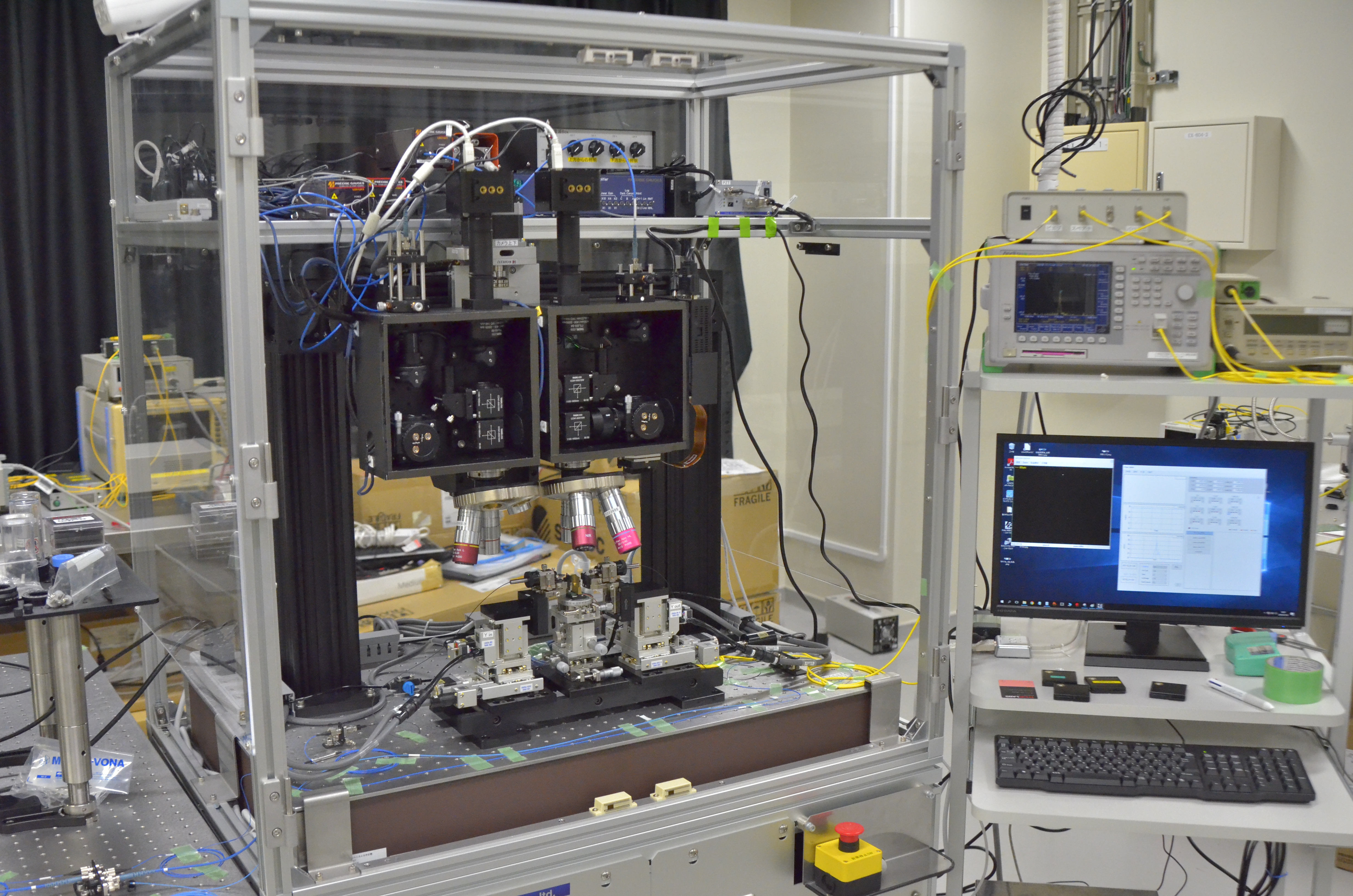
バー状にした複数の素子の透過特性を測定することができる装置です。全自動で調芯を行うとともに、空間位相変調した1550 nmの光および980 nmの光を、上部から素子に入射可能です。
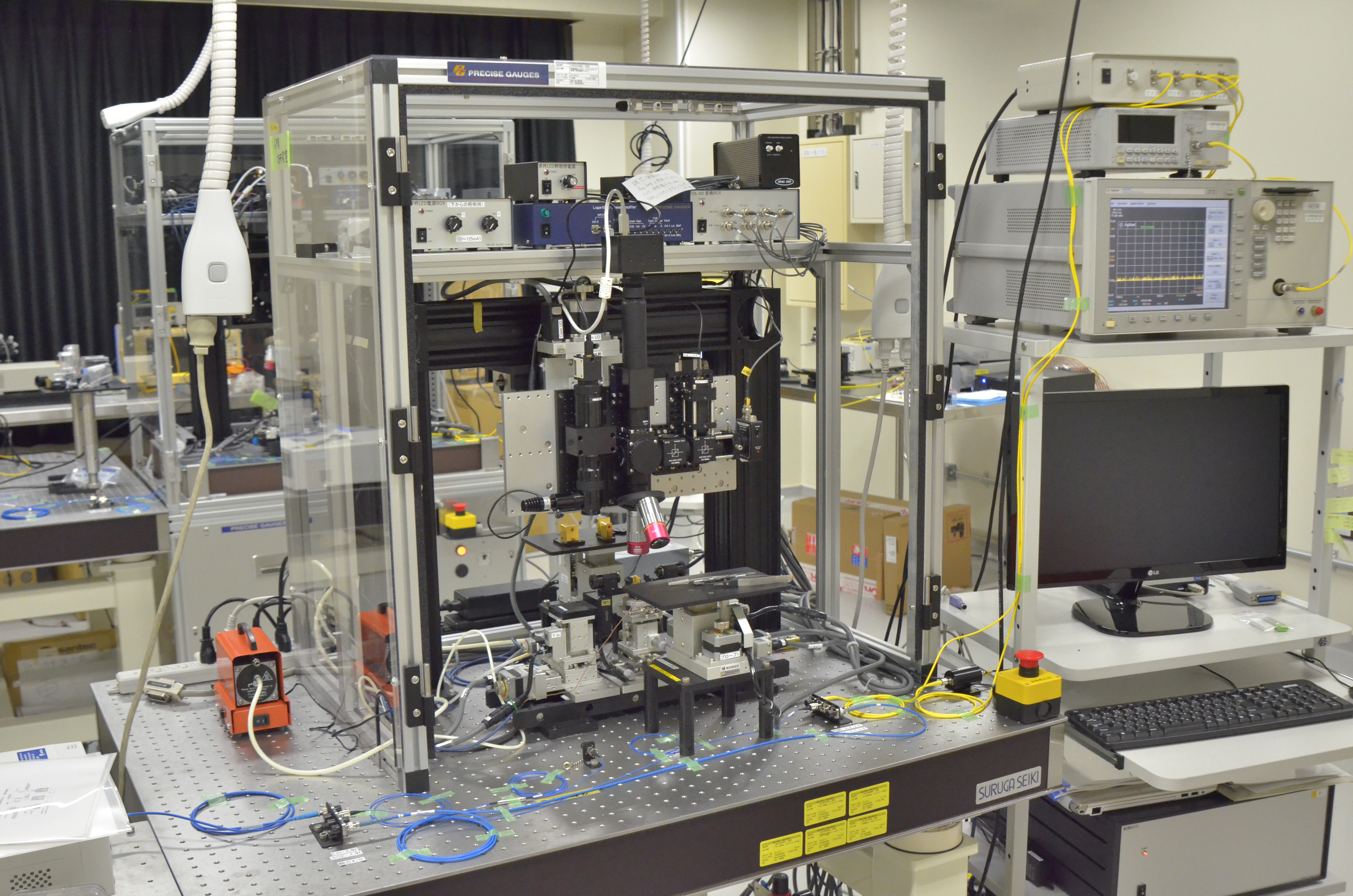
バー状にした複数の素子の透過特性を測定することができる装置です。全自動で調芯、および高周波プローブの配置などを行います。
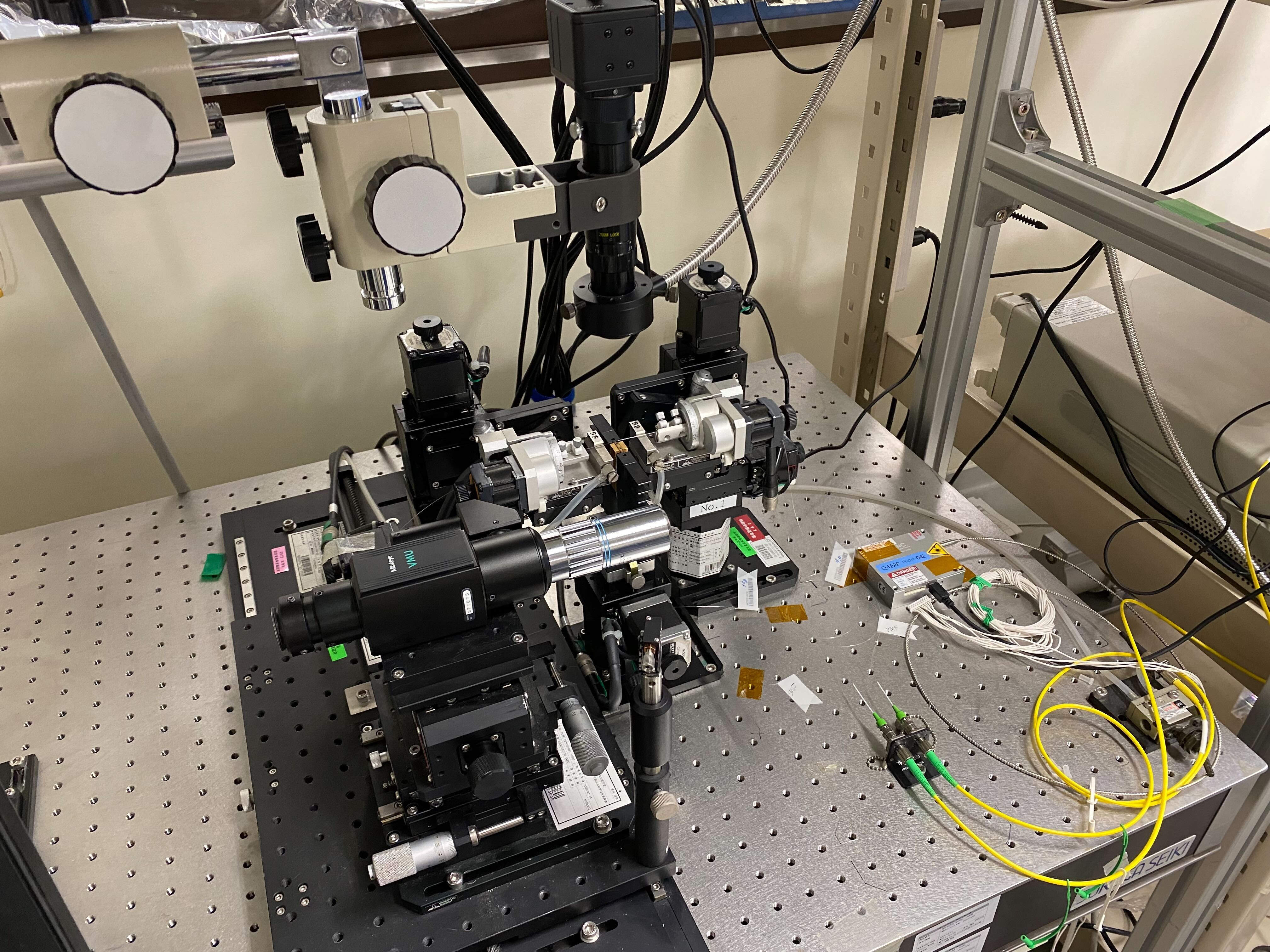
緑波長帯域の導波路損失測定します。
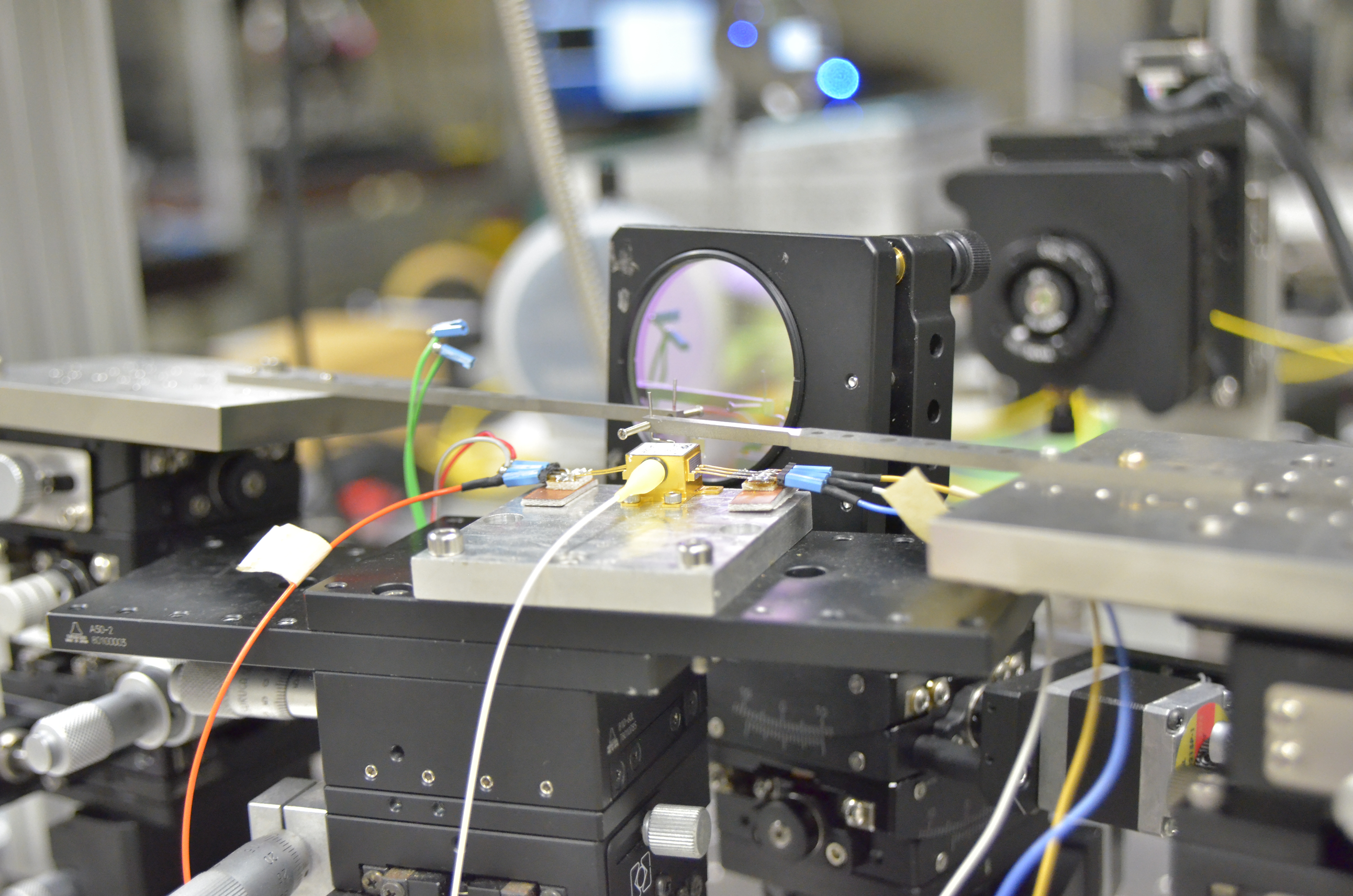
モジュール化した複数の素子を測定することができる装置です。電流-光、電流-電圧特性などのレーザ特性を半自動的に測定することができます。

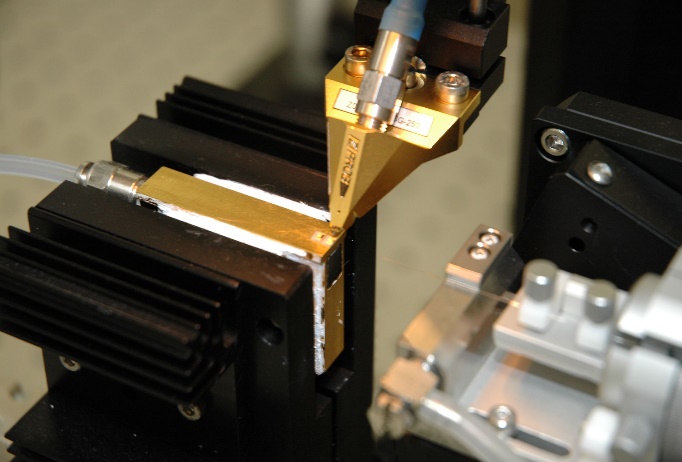
半導体レーザまたは外部変調器に高速信号を入力し、変調した光信号の品質を評価する測定系です。写真(上)の装置は任意の高速信号を生成するパルスパターンジェネレータ(写真の10Gbpsのほかに>50Gbpsも保有)、波形を観察できるサンプリングオシロスコープ、ビット誤り率測定装置です。その他、ネットワークアナライザやRIN測定装置などを保有しています。写真(下)では高速信号向けのプローブとファイバ調芯装置を用いて半導体レーザを直接変調する様子が写っています。
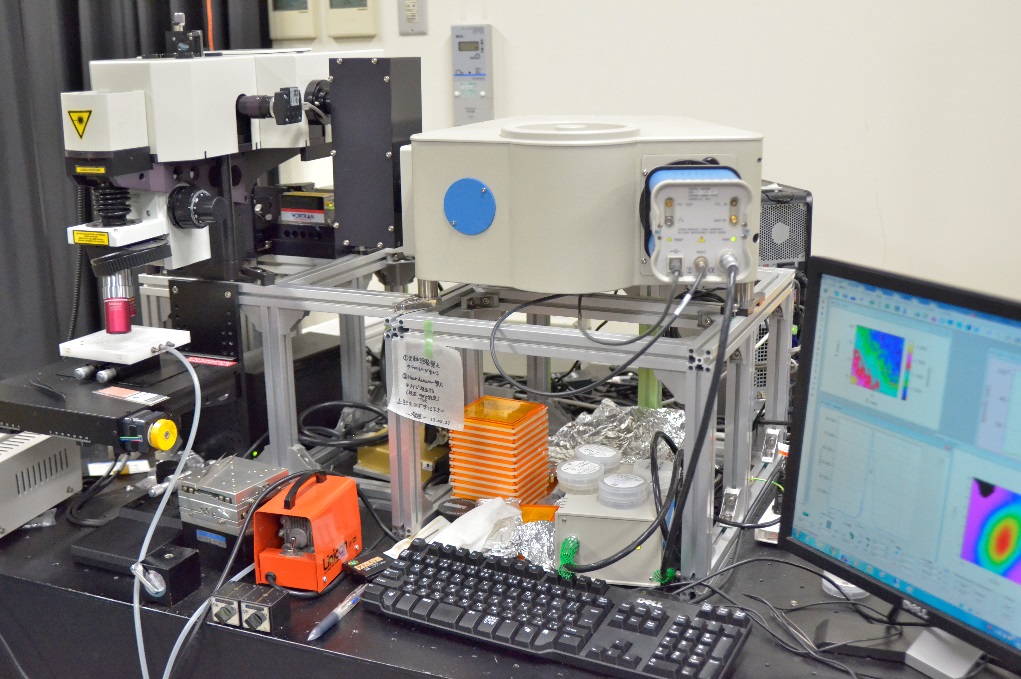
半導体のフォトルミネッセンス(PL)を測定する装置です。半導体に光を照射することで、電子と正孔が生成され、それがまた再結合することで、バンドギャップに対応したエネルギーの光が発生します。この光を分光装置によりスペクトルとして得ることで、半導体の特性を評価することが可能です。

赤外線を試料に集光し、測定部位をアパーチャーで絞り、高感度半導体検出器で吸収光(透過または反射光)を検知します。 微小領域について、主に有機構造に関する情報が赤外吸収スペクトルとして簡便に得られます。

紫外域から近赤外域にわたる広範囲な波長領域で微小試料や微小部位の透過・反射測定が行えます。

XRD: X-ray diffraction
成膜された半導体ウェハの層構造を解析する装置です。
X線の反射スペクトルを測定し、成膜された層の状態を推定します。
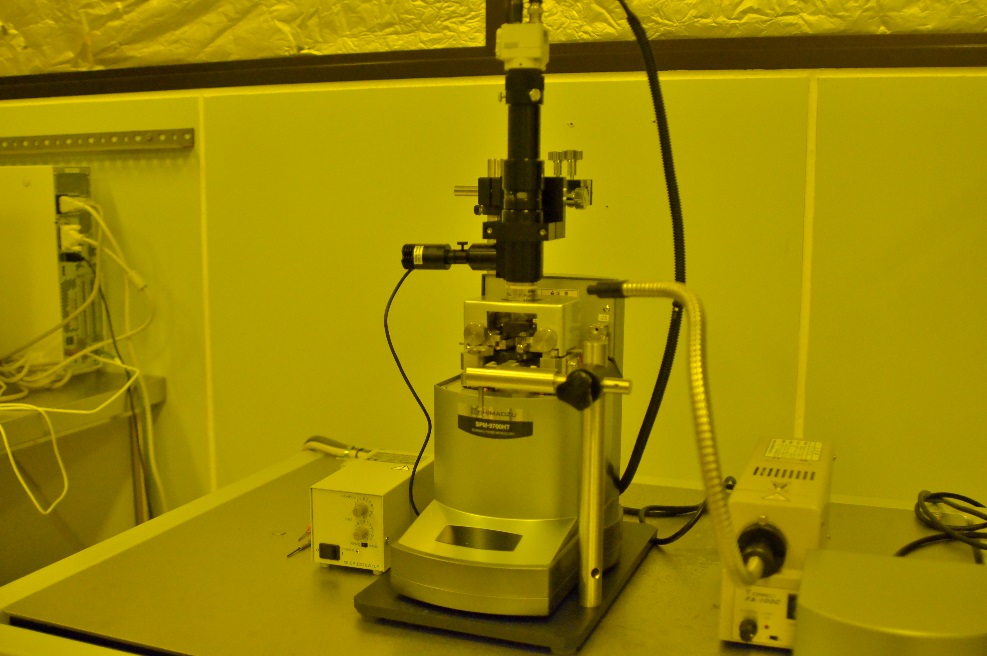
原子間力顕微鏡(AFM:Atomic Force Microscope)は探針と試料に作用する原子間力を検出するタイプの顕微鏡です。AFM探針は、片持ちバネ(カンチレバー)の先端に取り付けられています。この探針と試料表面を微小な力で接触させ、カンチレバーのたわみ量が一定になるように探針・試料間距離をフィードバック制御しながら水平に走査することで、表面形状を画像化します。
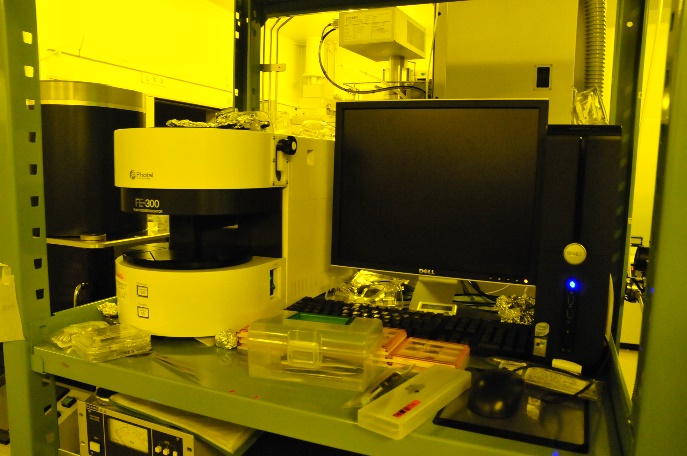
薄膜の膜厚を測定する装置です。
測定したい層の屈折率、吸収係数の波長特性を入れ込むことで正確な膜厚を得ることが出来ます。

本装置を用いると、半導体デバイス用薄膜(特に絶縁膜)に関する諸特性(誘電率、絶縁膜中電荷の評価、C-V特性、など)が測定できます。

最高の速度および精度を誇るボンドテスターです。大量生産環境における高速で正確かつ信頼性の高い接合試験のために最適化されています。

300mmウェハ及び200mmウェハ上の光デバイスの透過率評価を自動制御で高速に行うことが出来ます。
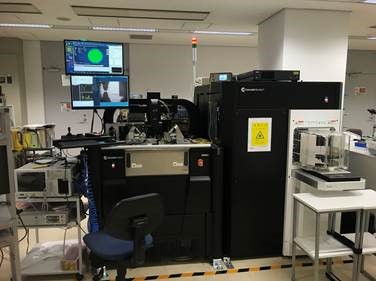
300mmウェハから小片チップまでの種々の基板上の光デバイスの特性評価を自動調心制御で行うことが出来ます。

(1)クロスライトソフトウェアインク社製の三次元半導体レーザシミュレータ PICS3D、半導体LEDシミュレータAPSYS。
(2)シノプシス社製のPhotonic Component Design Suite。
(3)ルメリカル社製のFDTD Solutions, INTERCONNECT, Lumericl DEVICE, MODE Solutions。
〒152-8550 東京都目黒区大岡山2-12-1-S9-1 03-5734-2555 ee.e titechnishiyama
西山教員室・西山研学生室[宮本研共通](南9号館 701号室・706号室・707号室)|
測定室(南9号館 604号室・502号室・201号室)|
クリーンルーム(南9号館 202号室・B1F 露光室)|
超高速エレクトロニクス研究棟